台积电准备新一代CoPoS封装技术:最快2028年末量产 英伟达有望是首个客户
6月12日快科技消息,据媒体报道,台积电正积极筹备新一代 CoPoS(Chip-on-Panel-on-Substrate) 封装技术,该技术能将封装基板尺寸显著扩展至310 x 310mm甚至更大。
CoPoS的核心创新在于将中介层面板化,这是对现有CoWoS-L和CoWoS-R(基于方形基板)的进一步演进。其本质是用大型矩形面板基板替代了传统的圆形晶圆作为载体。
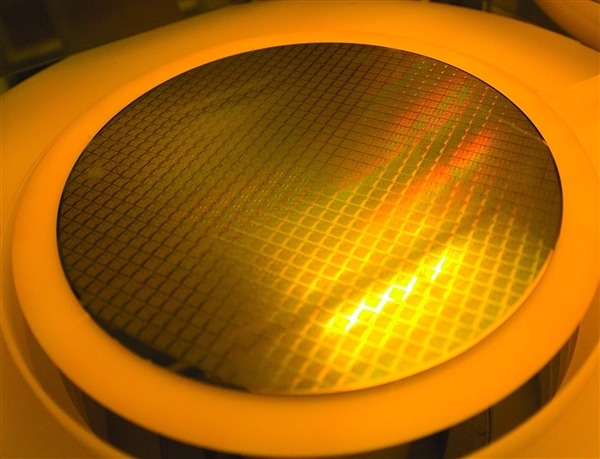
根据规划,台积电将于2026年建立CoPoS试点生产线,2027年重点进行工艺优化以满足合作伙伴需求,目标在2028年底至2029年初实现CoPoS量产。
与FOPLP(扇出型面板级封装)一样,CoPoS(基板上面板芯片封装)也采用大型面板基板进行封装,不过两者存在一些差异。FOPLP是一种不需要中介层的封装方法,芯片直接重新分布在面板基板上,并通过重分布层(RDL)互连。
这种方法具有成本低、I/O密度高、外形尺寸灵活等优势,适用于边缘AI、移动设备和集成密度适中的中端ASIC等应用。
CoPoS则引入了中介层,从而有着更高的信号完整性和稳定的功率传输,对于集成GPU和HBM芯片的高端产品来说效果更好。同时中介层材料正从传统的硅变为玻璃,将提供更高的成本效益和热稳定性。预计未来CoPoS将取代CoWoS-L,而英伟达很可能会是首个合作伙伴。
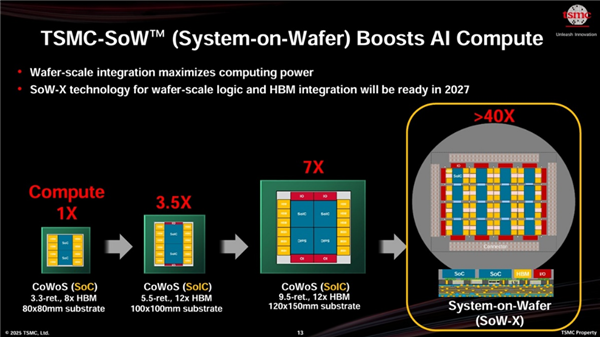
以上就是全部内容,喜欢的话记得收藏本站,我们将持续为您带来更多精彩内容。
